Навіщо використовувати матеріали High-k як матеріали шару діелектрика затвора?
Aug 15, 2024
Залишити повідомлення
Навіщо використовувати матеріали High-k як матеріали шару діелектрика затвора?
Як утворився діелектричний шар затвора? Чому передовий процес використовує високоякісні матеріали як шар діелектрика затвора?

Що використовується для шару діелектрика затвора вдосконалених вузлів?
|
Технологічний вузол |
Конструктивні особливості |
High-k Середній |
|
|
nMOS |
pMOS |
||
|
45 нм |
Площинний |
HfO₂/ZrO |
HfO₂/ZrO |
|
32 нм |
Площинний |
HfO₂ |
HfO₂ |
|
22 нм |
FinFET/Tri-gate |
HfO₂ |
HfO₂ |
|
14 нм |
FinFET/Tri-gate |
HfO₂ |
HfO₂ |
Як показано в таблиці вище, у вузлі 45 нм і нижче використовується процес HKMG (High-k Metal Gate), а матеріал з високим k використовується як шар діелектрика затвора; Вузли вище 45 нм в основному використовують оксид кремнію як шар діелектрика затвора.
Що таке затворний діелектричний шар?
Як показано на малюнку вище, сіра область у верхній частині діаграми представляє затвор, і напруга подається на затвор, щоб контролювати формування каналу струму між витоком і стоком. Світло-жовтий шар під затвором представляє шар діелектрика затвора, який ізолює затвор і монокристальну підкладку від провідності постійного струму.
Що таке струм витоку затвора?
Оскільки технологічний вузол зменшується, розмір мікросхеми зменшується, а шар оксиду затвора продовжує тоншати, і коли шар діелектрика затвора дуже тонкий (менше 2 нм) або при високій напрузі, електрони проходять через шар діелектрика через ефект тунелювання, що призводить до струму витоку між затвором і підкладкою.
Проблеми, викликані струмами витоку?
Енергоспоживання чіпа зростає, тепловиділення збільшується, а швидкість перемикання зменшується. Наприклад, у логічних схемах струми витоку можуть викликати дрейф рівня в логічних схемах на рівні затвора.
Навіщо використовувати високоякісні матеріали?
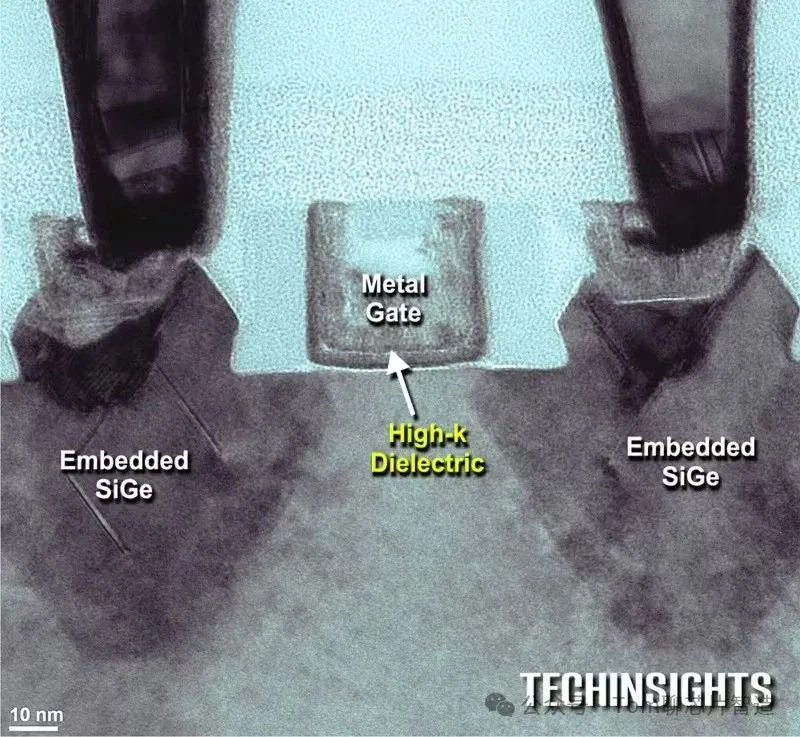
Діелектричні матеріали з високим коефіцієнтом k мають вищу діелектричну проникність (значення k), ніж звичайний SiO₂. Типи високоякісних носіїв:
|
High-k матеріал |
Діелектрична проникність |
|
Оксид гафнію HfO2 |
25 |
|
Оксид титану TiO2 |
30-80 |
|
Цирконій ZrO2 |
25 |
|
Пентоксид танталу Ta2O5 |
25-50 |
|
Титанат барію стронцію BST |
100-800 |
|
Стронцію титанат СТО |
230+ |
|
Титанат свинцю PZT |
400-1500 |
Формула ємності: C=ϵ⋅A\d
ε\d — діелектрична проникність, AA — площа конденсатора, dd — товщина шару діелектрика.
Як показано у формулі, чим більше ε при певному C, тим менше співвідношення A/d. Навіть з діелектриком з високим К можна збільшити товщину шару діелектрика, зберігаючи ємність. Фізична товщина високоякісних матеріалів більш ніж у 3-6 разів перевищує товщину оксиду кремнію, оскільки електронний тунельний струм експоненціально пов’язаний із товщиною ізоляційного шару, що значно зменшить ефект квантового тунелювання шару діелектрика затвора, тим самим ефективно покращуючи струм витоку затвора.
Послати повідомлення


